为确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构、缺陷相关,还是由于表面存在的氧化层,还是由于有机残由金刚石线锯切和标准浆锯切制成的180米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系。
利用日立S-4800扫描电子显微镜(SEM)、200keVJEOL201010F透射电子显微镜(TEM)和表面成像系统公司的原子力显微镜(AFM),通过研磨和离子研磨制备了截面透射电镜样品,采用基于光纤、光学排列的反射率测量。
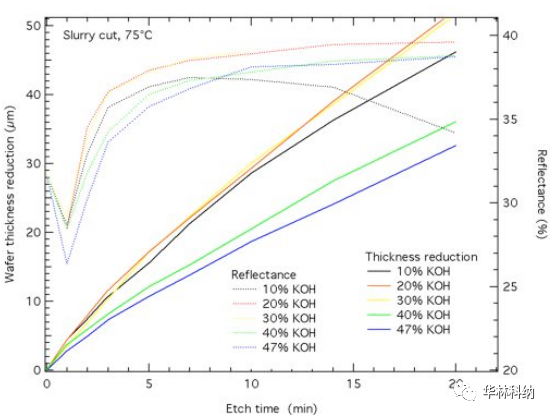
图1
图1为75°C下不同浓度氢氧化钾浆料切割片厚度降低,表面反射率随刻刻时间的变化,氢氧化钾浆料浓度在20-30%左右的刻刻率最大,加之反射率初降低是因为微裂纹的开口,增强了表面的纹理,图2为在75°C下不同浓度氢氧化钾浆料切割片厚度降低,表面反射率随刻刻时间降低,表面反射率初降低不明显,因为表面没有微裂纹。
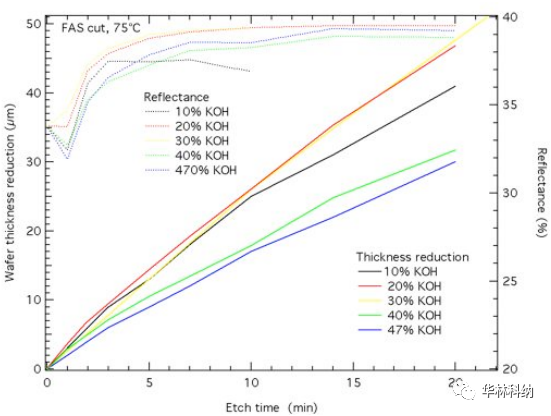
图2
FAS切割料切割片和FAS切割片的厚度降低,FAS切割片在初始时间5-10分钟内的蚀刻率较低,这在另一张图中得到了澄清,在氢氧化钾浓度分别为30%和47%的情况下,浆料和FAS切割片的厚度降低,对于超过10分钟的蚀刻时间,这两种类型的蚀刻率相同。
在浆液切面横截面上显示的是一层非晶Si(A-Si),具有20-40纳米的典型厚度,在非晶层下可以观察到300-600纳米厚的缺陷区;缺陷大多在表面800纳米的层中,但也有部分在2000纳米的深度。通过对比切割浆液和切割FAS芯片的表面结构横截面,FAS切割芯片的非晶层和缺陷层平均厚度为2-3倍,TEM观察到的非晶硅层在前2-5秒内根据腐蚀过程中初期测量的蚀刻率进行蚀刻,所以并不是初期蚀刻率下降的原因。
透射电镜调查也证实,在预清洗过程中,蚀刻率变化不大,表面没有氧化硅掩蔽层或有机残留层。
最后,随着时间的推移,FAS和标准浆片的碱性溶液的蚀刻速率随着温度的变化和不同的预清洗过程的变化而变化。结果表明,根据氢氧化钾的浓度和温度,氢氧化钾浓度的最大蚀刻速率约为20-30wt%,FAS晶片的蚀刻速率在最初5-10分钟的蚀刻过程中低于浆片;为了表示晶片表面,我们采用了扫描电子显微镜(SEM)、透射电子显微镜(TEM)、原子力显微镜(AFM)和反射率测量,通过比较切割浆料和切割FAS晶片的表面结构横截面,观察非晶硅层和缺陷层,但得出的结论是,对较高的初始蚀刻速率没有限制。
 手机:18202413255
手机:18202413255 固话:024-22739386
固话:024-22739386 邮箱:2267118907@qq.com
邮箱:2267118907@qq.com 地址:辽宁省沈阳市和平街安图街8号
地址:辽宁省沈阳市和平街安图街8号